以galss为核心材质,用于多孔介质多相流研究,通过光刻 + HF 各向同性刻蚀工艺实现 “顶面连通、底面不连通” 的 2.5D 多孔结构,区别于传统 2D 平面芯片和全 3D 多孔芯片,核心特征为刻蚀后晶粒顶面呈锯齿状、孔喉存在天然 “屏障 / 桥接” 结构。
一、核心材质
芯片整体为玻璃材质,加工过程中涉及辅助材料(铜膜、丙酮、去离子水等),密封环节采用玻璃盖片与基底玻璃键合,无其他高分子封装材料,适配高温密封(最高 690℃)和多相流试验的化学稳定性要求。
二、完整加工过程(含结构设计、刻蚀、清洗、密封)
加工核心围绕2D 蓝图设计→HF 各向同性刻蚀→分级清洗→玻璃键合密封四步展开,最终形成预设的孔体、孔喉、晶粒 2.5D 空间结构,各步骤细节及对应结构特征如下:
步骤 1:2D 蓝图设计(多孔介质基础构型)
- 设计内容:在 2D 蓝图上绘制规则排布的孔体(pore-bodies),单个孔体由圆形主体 + 4 个矩形边缘构成;相邻孔体在蓝图中完全不连通,孔体区域为后续 UV 曝光、HF 刻蚀的目标区域。
- 设计目的:为后续刻蚀提供基础构型,通过 “非连通孔体” 设计,结合 HF 各向同性刻蚀的侧向腐蚀特性,形成 2.5D 连通结构。
步骤 2:HF 各向同性刻蚀(2.5D 结构核心成型)
这是实现 2.5D 结构的关键步骤,利用 HF 刻蚀的各向同性特性(水平、垂直刻蚀速率一致)对玻璃基底进行刻蚀:
- 预设刻蚀深度为23μm,该深度与顶面水平刻蚀距离基本一致;
- 刻蚀后相邻孔体从顶面实现连通,但底面仍保持不连通;
- 未刻蚀的玻璃区域(晶粒)顶面形成锯齿状(jagged)圆形结构,刻蚀水平方向如 Fig.S1 红色箭头所示。
- 核心结构特征:刻蚀后形成孔体 – 孔喉 – 晶粒的三级结构,孔喉处存在天然的 “壁 / 坝(wall/dam)”,既是两个孔体间的屏障,也是相邻晶粒边缘的桥接结构(Fig.S2)。
步骤 3:分级清洗(刻蚀后清洗 + 试验后清洗,保障芯片洁净度)
玻璃芯片的 2.5D 结构存在非平面连通通道,清洗难度高,因此设计刻蚀后初次清洗和试验后重复清洗两套标准流程,均为物理 + 化学结合的清洗方式:
(1)HF 刻蚀后清洗(为密封做准备,去除刻蚀残留 / 无机 / 有机污染物)
- 浸入铜刻蚀剂,清除残留铜膜和颗粒;
- 肥皂水配合棉签反复擦拭多孔介质区域(玻璃硬度高,强力擦拭无损伤);
- 去离子水冲洗,显微镜下复检,去除棉签纤维;
- 丙酮冲洗,清除前期操作的有机污染物;
- 玻璃盖片重复步骤 2-4,保证键合面洁净;
- 丙酮润湿芯片基底,快速贴合盖片,强力按压排出缝隙丙酮;
- 60℃加热蒸发剩余丙酮,显微镜复检;若存在无机污染物,重复 1-6 步(少量有机污染物可通过后续高温密封去除)。
(2)试验后清洗(为重复试验做准备,去除油相 / 水相残留)
- 轻质油(C6-C10)以 100μL/hr 流速冲洗 3 倍孔隙体积(3PV);
- 去离子水以相同流速冲洗 3PV;
- 乙醇冲洗至显微镜下无油水界面;
- 去离子水再次冲洗 3PV;
- 120℃加热 2 小时,烘干芯片。
步骤 4:高温密封(玻璃键合,实现芯片封闭)
刻蚀后清洗完成后,将贴合的玻璃基底与盖片置于最高 690℃ 环境下高温密封,实现玻璃 – 玻璃的无缝键合,既清除残留的少量有机污染物,又保证芯片的密封性,满足多孔介质多相流试验的防泄漏要求。
步骤 5:结构表征( profilometer 轮廓仪验证)
采用轮廓仪(profilometer) 从非垂直视角对密封前的芯片进行 3D 结构表征(Fig.S2),可清晰识别晶粒、孔体、孔喉的空间分布,验证其与 2D 蓝图设计的一致性,同时可观察到非垂直的孔边缘和孔喉处的 “壁 / 坝” 结构。
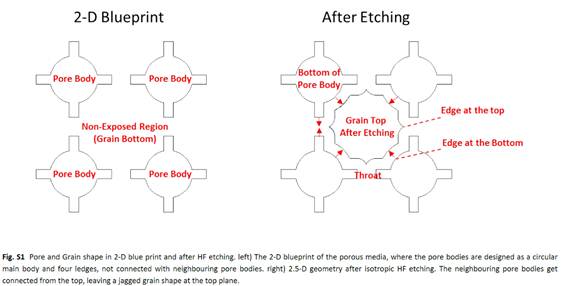
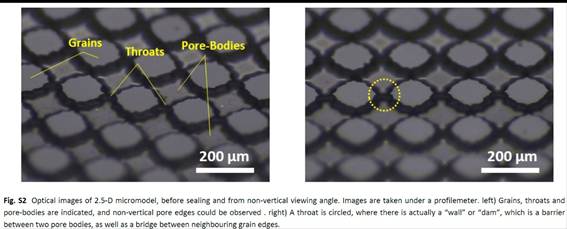
© 2026. All Rights Reserved. 苏ICP备2022036544号-1












